Разработка GаN-транзисторов
Введение
Возможности СВЧ-приборов напрямую связаны с электрофизическими параметрами применяемых полупроводниковых материалов. Для мощных кремниевых транзисторов L‑ и S‑диапазоны частот уже являются предельными. Традиционные решения в области более высоких частот на арсениде галлия не позволяют получить высокую мощность из-за низких напряжений питания.
В последние несколько десятилетий, благодаря развитию технологии создания приборов на основе нитрида галлия (GaN), удалось получать транзисторные структуры, значительно превосходящие привычные транзисторы на основе кремния и арсенида галлия. Успешное применение высококачественных структур нитрида галлия позволило не только создавать СВЧ-приборы высокой мощности для работы в S‑, C‑ и X‑диапазонах частот, но и использовать эту технологию в силовой электронике.
Упоминание транзисторных структур на нитриде галлия впервые появилось в статье 1993 года от разработчиков APA Optics [1]. GaN-транзисторы обладают выдающимися электрофизическими свойствами: сравнительно высокой подвижностью и высокой скоростью насыщения электронов, высоким пробивным напряжением, достаточно высокой теплопроводностью и высокой рабочей температурой (табл. 1).
|
Материал |
Ширина запрещенной зоны, эВ |
Критическая напряженность, мВ/см |
Подвижность электронов, см2/(В•с) |
Скорость насыщения, см/с•107 |
Рабочая температура, °С (макс.) |
|
Si |
1,1 |
0,3 |
1300 |
1 |
> 200 |
|
SiC |
3,26 |
2 |
700 |
2 |
< 500 |
|
GaAs |
1,42 |
0,4 |
6000 |
1 |
> 300 |
|
GaN |
3,49 |
3,3 |
1500 |
1,5 |
< 500 |
Благодаря этим свойствам, на основе GaN-гетероструктур создаются полевые транзисторы с высокой подвижностью электронов (HEMT), которым свойственны высокие показатели выходной мощности, коэффициента полезного действия и коэффициента усиления на высокой рабочей частоте.
Высокое напряжение питания нитрид-галлиевых СВЧ-транзисторов и малые межэлектродные емкости позволяют легко выполнять согласование в широкой полосе частот. Кроме того, большие запасы по пробивному напряжению сток-исток обеспечивают непревзойденную стойкость к рассогласованию нагрузки транзистора.
Специалисты АО «НИИЭТ» имеют богатый опыт в плане разработки приборов на основе GaN. К настоящему моменту создано и серийно поставляется свыше 30 типов приборов широкого спектра применения. Объемы поставок продукции превышают 3000 шт. В данном обзоре приводятся результаты работы специалистов АО «НИИЭТ» в области создания приборов на основе нитрида галлия.
Мощные СВЧ-приборы на основе GaN
Обладая высокой подвижностью носителей заряда, а также высокими значениями критического поля пробоя, нитрид галлия оптимален для создания мощных СВЧ-транзисторов. Из-за сложности в выращивании собственных подложек нитрида галлия для мощных СВЧ-транзисторов чаще всего используют подожки из чистого карбида кремния. Этот материал обладает низким рассогласованием кристаллических решеток с нитридом галлия, что позволяет минимизировать количество переходных слоев при эпитаксиальном выращивании. Карбид кремния отличается высокой теплопроводностью, поэтому можно получать высокие значения удельной мощности в приборах с подложкой на его основе [2]. С другой стороны, подложки карбида кремния до сих пор имеют относительно высокую стоимость, что во многом определяет высокую стоимость готовых транзисторов.
На рис. 1 изображено поперечное сечение GaN HEMT-структуры. Характерным элементом в ней являются сквозные отверстия, соединяющие истоковые области с подложкой транзистора. Такое решение значительно снижает индуктивность истока и упрощает монтаж кристалла в корпус [3].
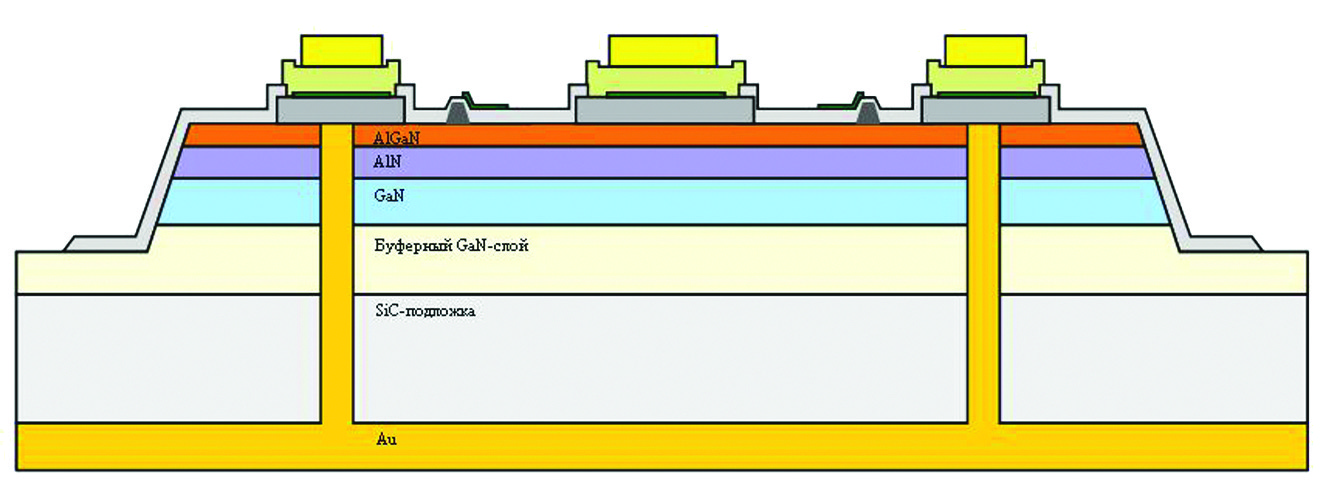
Рис. 1. Схематическое изображение разреза транзисторной ячейки с металлизированными сквозными отверстиями в активной области
Важной частью мощного СВЧ-транзистора являются внутренние цепи согласования. Для примера на рис. 2 показан транзистор 6П9143А3 с внутренними цепями согласования, который, по сути, представляет собой однокаскадный усилитель мощности в гибридно-интегральном исполнении.
Транзистор полностью согласован на 50 Ом и предназначен для применения в составе приемо-передающей аппаратуры C‑ и X‑диапазона частот. Все элементы согласующих цепей, такие как керамические платы, МДП-конденсаторы, пленочные резисторы, изготавливались по микроэлектронному техпроцессу на собственном производстве.
Основные технические характеристики изделия 6П9143А3:
- диапазон частот: 7,7–8,7 ГГц;
- непрерывная выходная мощность при компрессии коэффициента усиления на 1 дБ: более 30 Вт;
- типовой коэффициент усиления в линейном режиме: не менее 13 дБ;
- коэффициент полезного действия: не менее 40%.
АО «НИИЭТ» является единственным серийным отечественным производителем СВЧ мощных GaN-транзисторов как для гражданского рынка, так и для аппаратуры специального назначения. Объем поставок данной продукции в настоящее время превысило 3000 шт.
В таблицах 2 и 3 приведены параметры разработанных АО «НИИЭТ» СВЧ мощных GaN-транзисторов. Следует отметить, что в таблице указаны минимальные значения коэффициента усиления по мощности и коэффициента полезного действия стока транзистора, в отличие от зарубежных спецификаций, приводящих типовые значения.
|
Прибор |
Uпит, В |
fтест, МГц |
Pвых, Вт |
КУР_мин, дБ |
КПДмин, % |
|
ПП9136А |
28 |
4 |
5 |
16 |
50 |
|
ПП9137А |
28 |
4 |
10 |
14 |
50 |
|
ПП9138А |
28 |
4 |
15 |
12 |
50 |
|
ПП9138Б |
28 |
4 |
25 |
10 |
50 |
|
ПП9139А1 |
28 |
2,9 |
50 |
12 |
50 |
|
ПП9139Б1 |
28 |
1,6 |
100 |
13 |
45 |
|
ТНГ270100-28 |
28 |
2,7 |
100 |
9 |
60 |
|
ТНГ310100-50 |
50 |
3,1 |
100 |
11 |
50 |
|
ТНГ310150-50 |
50 |
3,1 |
150 |
11 |
50 |
|
ТНГ400100-50 |
50 |
4,0 |
100 |
12 |
50 |
|
ТНГ400050-50 |
50 |
4,0 |
50 |
12 |
50 |
|
ТНГ200200-50 |
50 |
2,0 |
200 |
13 |
50 |
|
ТНГ600050-50 |
50 |
6,0 |
50 |
12 |
46 |
|
Прибор |
Uпит, В |
fтест, МГц |
Pвых, Вт |
КУР_мин, дБ |
КПДмин, % |
|
6П9140А |
50 |
1,6 |
400 |
12 |
60 |
|
6П9141А1 |
28 |
1,7 |
80 |
17 |
65 |
|
6П9141Б1 |
28 |
2,5 |
60 |
15 |
65 |
|
6П9142А2 |
28 |
4 |
20 |
13 |
45 |
|
6П9142Б2 |
28 |
4 |
2 |
13,5 |
45 |
|
6П9143А3 |
28 |
7,7–8,7 |
30 |
12 |
35 |
|
6П9143Б2 |
28 |
7,7–8,7 |
5 |
13 |
30 |
|
6П9144А4 |
28 |
12 |
0,5 |
13,5 |
20 |
|
6П9144Б4 |
28 |
12 |
0,12 |
14,5 |
20 |
|
6П9145А2 |
28 |
4 |
5 |
13 |
45 |
|
6П9145Б2 |
28 |
4 |
10 |
10 |
45 |
|
6П9145В2 |
28 |
4 |
15 |
10 |
45 |
|
6П9145Г2 |
28 |
4 |
25 |
9 |
45 |
|
6П9146А1 |
28 |
1,5 |
100 |
13 |
45 |
Также ведутся разработки по расширению номенклатуры мощных СВЧ GaN-транзисторов. Спроектированы следующие транзисторные кристаллы:
- 10 и 25 Вт с Uпит = 50 В в CW-режиме для S‑диапазона.
- 75 Вт с Uпит = 40 В для X‑диапазона.
- 100 Вт с Uпит = 50 В в CW-режиме для S‑диапазона.
- 250 и 350 Вт с Uпит = 50 В для С‑диапазона.
- 1000 и 1200 Вт с Uпит = 50 В для L‑диапазона.
Параллельным направлением развития СВЧ GaN-приборов в АО «НИИЭТ» является заказная разработка малогабаритных гибридных усилителей мощности в стандартных транзисторных корпусах. Примером такого прибора может служить усилитель L‑диапазона МУМ‑60. Данный модуль изготовлен по технологии ГИС СВЧ и полностью согласован на 50 Ом. Усилительными элементами служат нитрид-галлиевые транзисторные кристаллы. Внешний вид усилителя без герметизирующей крышки показан на рис. 3.
Основные технические характеристики изделия МУМ‑60:
- диапазон частот: 1090–1700 МГц;
- импульсная выходная мощность: более 60 Вт;
- коэффициент полезного действия: более 50%;
- длительность импульса: 1 мс, скважность 5;
- типовой коэффициент усиления: 38 дБ;
- время включения/выключения: менее 1/4 мкс;
- габаритные размеры: 24×17,4×4,8 мм;
- масса: 7 г.
К особенностям этого модуля следует отнести его малые размеры и массу, что очень важно при построении современных радиолокационных систем. Кроме того, несмотря на малые размеры, в модуль встроены все необходимые функциональные блоки, такие как цепи смещения, развязки и управления по постоянному току, фильтры питания с накопительными керамическими конденсаторами.
Модуль МУМ‑60 имеет вход высокоскоростного управления, позволяющий менее чем за четверть микросекунды выполнять операцию включения и выключения. Данная особенность повышает КПД и сокращает просачивание сигнала и шума в паузах между импульсами. Кроме того, вход управления можно использовать для импульсной модуляции выходного сигнала. Фазочастотная характеристика модуля имеет монотонный характер без резких скачков и изгибов. Модуль МУМ‑60 не имеет аналогов.
Транзисторы на основе структур GaN-on-Si
Высокие значения пробивных напряжений при относительно низком сопротивлении в открытом состоянии делают приборы на основе нитрида галлия перспективными для применения в силовой электронике. Поскольку нитрид галлия отличается от кремния повышенной подвижностью электронов и большей электрической прочностью, при заданных значениях сопротивления и пробивного напряжения GaN-транзистор имеет меньшие размеры по сравнению с кремниевым аналогом. Обратным эффектом является значительное снижение теплопроводности подложки, что для транзисторов, работающих в ключевом режиме, не столь критично, как для транзисторов, действующих в усилительном режиме. GaN-транзисторы, функционирующие в ключевом режиме, также обладают чрезвычайно высокой скоростью переключений и минимальным временем обратного восстановления, что является важным условием для уменьшения потерь и повышения эффективности [4].
По сравнению с Si-аналогами, GaN силовые транзисторы имеют следующие достоинства:
- у транзисторов на основе GaN-структур сопротивление открытого канала RON имеет очень низкое значение, в результате чего минимизируется количество статических потерь;
- вследствие минимальной входной емкости высокая скорость переключения обеспечивает их применение в приборах с большими выходными токами и увеличением рабочих частот до нескольких сотен МГц;
- при увеличении рабочих частот также возможно повышение эффективности ключа — это позволит снизить значение емкостей и индуктивностей выходных фильтров, а соответственно, и габаритные размеры транзистора без потери рабочих параметров.
Однако, несмотря на все преимущества силовых GaN-транзисторов, прогресс в данном направлении в значительной мере ограничивался высокой стоимостью таких приборов. Но с появлением технологии выращивания низкодефектных эпитаксиальных структур нитрида галлия на кремнии стало возможным значительно уменьшить стоимость конечного транзистора. К тому же, переход к гетероструктурам GaN-on-Si позволил сделать качественный скачок в увеличении диаметра пластин (рис. 4). Однако гетероструктуры GaN-on-Si имеют один недостаток, который может создавать проблемы для пользователей.
Из-за различия в размере кристаллической решетки Si (3,85) и GaN (3,19) пластины с эпитаксиальными структурами GaN-on-Si подвержены механическим деформациям и прогибу, особенно при увеличении толщины эпитаксиальной пленки GaN и диаметра пластин. Быстрому освоению данной GaN-технологии способствовали успехи в разработке и промышленном освоении оборудования и технологии эпитаксиального наращивания GaN на подложках кремния большого диаметра — 150 и 200 мм.
На рис. 5 приведено схематическое изображение GaN-транзисторной структуры на кремниевой подложке. Ключевым отличием от структуры на рис. 1 является отсутствие сквозных металлизированных отверстий в истоках структуры.
Специалистами АО «НИИЭТ» разработан ряд переключающих GaN-транзисторов с напряжением 100, 200 и 650 В с низким значением RON (табл. 4).
|
Тип |
Максимально допустимое напряжение сток-исток UСИ, В |
Постоянный ток стока IC, А |
Сопротивление сток-исток в открытом состоянии RСИ_отк, Ом |
Заряд затвора QG, нКл |
|
ТНГ-К 100030-30 |
100 |
30 |
0,03 |
3,3 |
|
ТНГ-К 200040-30 |
200 |
40 |
0,03 |
4,4 |
|
ТНГ-К 200020-70 |
200 |
20 |
0,07 |
5,6 |
|
ТНГ-К 650020-100 |
650 |
20 |
0,1 |
4,5 |
|
ТНГ-К 650030-50 |
650 |
30 |
0,05 |
6,1 |
Данные транзисторы разрабатывались для поверхностного монтажа (SMD) с использованием металлокерамических корпусов по типу КТ‑93 (SMD‑0.5) и КТ94 (SMD‑1) и пластиковых корпусов по типу КТ‑89 (DPACK) и КТ‑90 (D2PACK) (рис. 6).
В планах на будущее — доработка топологии силовых кристаллов для их монтажа по технологии Flip-Chip, что обеспечит снижение паразитных параметров и поспособствует уменьшению габаритных размеров конечного устройства.
Заключение
В статье приведены успехи АО «НИИЭТ» в сфере разработки и реализации приборов на основе нитрида галлия. Номенклатурный ряд поставляемых устройств обширен и включает в себя:
- мощные СВЧ-транзисторы для диапазонов частот от L до X;
- силовые переключающие с малым значением RСИ_отк;
- малогабаритные усилители мощности.
В планах развития на ближайшее будущее основными направлениями АО «НИИЭТ» являются:
- получение мощных СВЧ-приборов с выходной мощностью свыше 1000 и 75 Вт для L‑ и X‑диапазонов частот соответственно;
- расширение номенклатурного ряда производимых устройств для удовлетворения потребностей, связанных с GaN-приборами как для гражданского рынка, так и для аппаратуры специального назначения;
- увеличение объема выпуска уже готовых устройств на основе GaN для массовой поставки всем заинтересованным предприятиям.
- Khan M. A., Kuznia J. N., Bhattaral A. R., Olsen D. T. Metal semiconductor field effect transistor based on single crystal GaN//Appl.Phys.Lett. 1993. 62. No. 15.
- Тарасов С. В., Дикарев В. И., Цоцорин А. Н. Мощные GaN-транзисторы для применения в перспективных системах связи и радиолокации//Электронные компоненты. 2017. № 7.
- Тарасов С. В. и др. Мощные GaN-транзисторы S‑, С‑, Х‑диапазонов частот//Электроника и микроэлектроника СВЧ. 2018. Спецвыпуск.
- Schweber B. GaN Power Devices: Potential, Benefits, and Keys to Successful//EIU EUROPE. 2018. No 1.






 1 сентября, 2020
1 сентября, 2020 7 июля, 2020
7 июля, 2020 22 мая, 2020
22 мая, 2020